
Electron Density Dependence of the Excitonic Absorption Thresholds of GaAs Quantum Wells
丂phys. stat. sol. 2000 R.Kaur
1.Introduction
丂
丂exciton偲偼揹巕偲惓岴(hole)偺懳偲側偭偰偄傞傕偺偱偁傞丅Coulomb interaction偱偮偄偵側偭偰偄傞偺偱偁傞偑丄偙傟偼柧傜偐偵悈慺尨巕偺柾宆偲帡偰偄傞丅偮傑傝丄僄僱儖僊乕弨埵偲偟偰悈慺偺僄僱儖僊乕弨埵偺傛偆側傕偺傪帩偭偰偄傞偲偄偆偙偲偱偁傞丅偙傟傜偺exciton岠壥偼擇師尦検巕堜屗偺拞偱嫮傔傜傟傞丅掅壏偺拞偱偺検巕堜屗偺媧廂偼1s偺exciton偺偨傔peak偼晛捠偺媧廂(continuum)偲暘楐偟偰尒傜傟傞丅偟偐傕懠偺2s,3s偺側偳傗懇敍偺側偄揱摫懷(continuum)偐傜偺媧廂偑尒傜傟傞丅
丂偨偲偊偽GaAs偺傛偆側傕偺偺応崌1s偺exciton偺懇敍僄僱儖僊乕偼5乣15meV偱偁傞丅偙傟偼堜屗偺暆偵埶懚偡傞丅
丂exciton偺岠壥偼枾側揹巕gas偑懚嵼偡傟偽婃屌偵懚懕偡傞偙偲偼抦傜傟偰偄傞丅検巕堜屗偺interband(僶儞僪娫)偺慗堏偼媧廂偟偨僼僅僩儞偺僄僱儖僊乕嬤偔偵堦偮偺鑷抣偑偁傞丅僼僃儖儈僄僱儖僊乕晅嬤偱椼婲偝傟偨揹巕偲儂乕儖偼僋乕儘儞憡屳嶌梡偵傛偭偰怳摦巕嫮搙傪嫮傔丄偦偺鑷抣偺嬤偔偵庛偄peak偑尒傜傟傞丅偙偺庛偄peak偼fermi edge singularity偲屇偽傟偰偄偰丄嬥懏偺X慄偺僗儁僋僩儖偱尒傜傟傞丅(偙傟偵娭偟偰偼懠偺榑暥偱夝愢偡傞丅)
丂偙偺傎偐偵GaAs/AlGaAs偺崅堏摦搙(揹巕偑摦偒傗偡偄偲偄偆偙偲)偺僩儔儞僕僗僞乕偱偼丄揹巕偑懡彮夁忚偵偁傞忬懺偱揹巕擹搙傪僐儞僩儘乕儖偡傞偙偲偱偄傠偄傠側柺敀偄岝妛摿惈偑尒傜傟傞丅嵟嬤偱偼偲偰傕揹巕擹搙偺掅偄忬懺(1010cm-2)偱exciton偺傕偆1偮偺忬懺偑尒偮偐偭偨丅偙傟傜偼charged exciton偲屇偽傟偄偰丄exciton偵1偮偺壸揹巕(惓偱傕晧偺揹壸偱傕傛偄)偑偮偄偰寁俁偮偺暋崌忬懺(trion)偱偁傞丅梋暘側暘偺晧偺揹壸偑偮偄偨偲偒偵偼壸揹椼婲巕(X-)偺梋暘側懇敍僄僱儖僊乕偼揟宆揑偵偼1乣2meV(GaAs QWs)偱偁傞丅杮榑暥偱偼擇師尦揹巕宯偱偺壸揹椼婲巕偺懚嵼偵娭偟偰弎傋偨榑暥偱偁傞丅
丂intro側偺偱榖偑偦傟傞偑combescot側偳偼嬥懏偱偺X慄椞堟偺僗儁僋僩儖傪揹巕擹搙偺帇揰偱媍榑偟偰偄傞丅揔摉側揹巕擹搙偱偼揹巕偼擇偮偺媧廂鑷抣傪帩偮丅偙傟偼hole偑揹巕偲懇敍偟偰偄傞偐偟偰偄側偄偐偵傛傞忬懺偺堘偄偵懳墳偟偰偄傞丅擇偮偺鑷抣偺僄僱儖僊乕嵎偼懇敍僄僱儖僊乕(exciton偺懇敍僄僱儖僊乕傪怳傝暐偆暘)偲femi energy暘(揹巕偑媗傑偭偰偄傞偲偙傠傑偱)偺榓偱偁傞丅偙偺鑷抣偼偦傟傜偺掅僄僱儖僊乕懁偱shake-up-process(婡夛偑偁傟偽偦傟偵娭偟偰懠偺榑暥偱弎傋傞丄娙扨偵尵偆偲揹巕偺撪妅揹巕傗拞娫妅揹巕偑揹棧偵傛偭偰偦傟傜偺桳岠揹壸偑媫寖偵曄壔偡傞偲偒偵奜懁偺揹巕偑億僥儞僔儍儖偺曄壔傪姶偠偱椼婲弨埵傊慗堏偡傞夁掱丅撪妅丄拞娫妅偺揹棧偼僆乕僕僃夁掱偵傛偭偰惗偠傞揹巕偑妅奜傊慗堏偡傞夁掱偼shake-off-process偲偄偆偙偺夁掱偺媡偼shake-off-process偲偄偆)偵傛偭偰tail傪堷偔偙偲偑抦傜傟偰偄傞丅
丂Hawrylak偼擇師尦揹巕宯偱偺椼婲巕媧廂僗儁僋僩儖傪寁嶼偟偨丅Later Brown 偼壸揹椼婲巕偺媧廂僗儁僋僩儖偵娭偟偰寁嶼偟偨丅偙偺偲偒偼鑷抣偼嶰偮懚嵼偡傞丅壸揹椼婲巕偲椼婲巕偲捠忢偺fermi energy偱偺媧廂偲偹丅慄暆偼斵傜偺僒儞僾儖偱偼柧妋偵暘棧偡傞偙偲偑偱偒側偐偭偨偑丄嫟柭偱偺僗儁僋僩儖偺宍偼棟榑揑側傕偺偲堦抳偟偰偄偨丅
丂杮榑暥偱偼愭傎偳傕弎傋偨傛偆偵崅弮搙偱堜屗偐傜墦偔偵dope偟偨丄gate揹埑偱揹巕擹搙傪僐儞僩儘乕儖偟偨GaAs偺検巕堜屗偺PLE僗儁僋僩儖傪曬崘偡傞丅light-hole偲偺敪岝傪暘棧偡傞偨傔偵斾妑揑嫹偄検巕堜屗傪梡偄偨丅
2.Experimental Details
丂丂丂丂丂丂
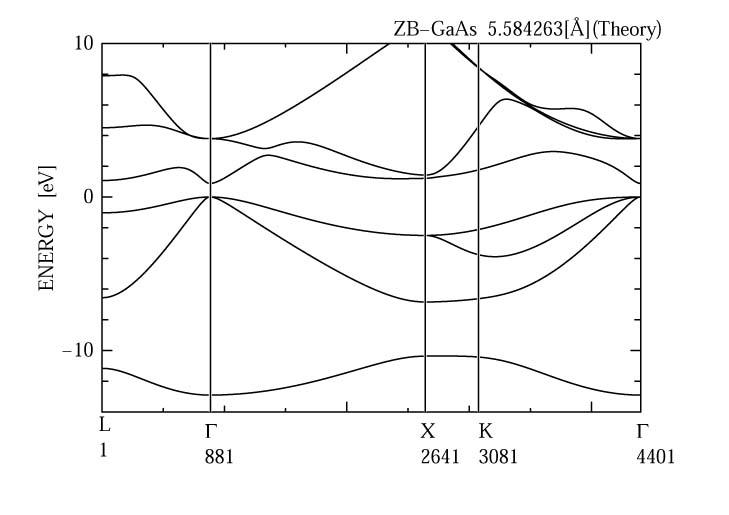
丂丂丂丂丂丂丂丂
 丂丂丂丂
丂丂丂丂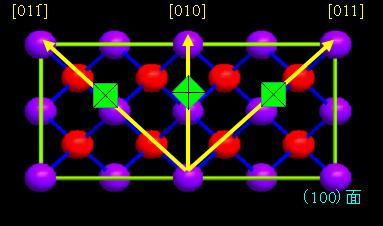
丂崱夞梡偄偨帋椏偼MBE偱GaAs偺婎斦偺(100)曽岦偵寢徎惉挿偝偣偨傕偺偱丄100侌偺GaAs偺検巕堜屗傪埖偭偨丅1兪m偺GaAs丄1兪m偺AlGaAs丄0.5兪m偺挻奿巕(暋悢偺庬椶偺寢徎奿巕偺廳偹崌傢偣偵傛傝丄偦偺廃婜峔憿偑婎杮扨埵奿巕傛傝挿偔側偭偨寢徎奿巕偺偙偲丅)GaAs(25侌)/AlGaAs(25侌)
丄偦偺GaAs偺QW偼600侌偺undoped偺AlGaAs偺spacer丄2000侌AlGaAs(si-doped1017cm-3)偦偟偰170侌偺GaAs偺cap傪傕偪偄偨丅sample偼FET偺schotky contact 偲丂堜屗偵Ohmic contact偱弨旛偟偨丅ohmic contactst偲gate偱揹巕傪0乣3亊1011cm-2傑偱堜屗撪偺揹巕枾搙傪僐儞僩儘乕儖偱偒傞丅
3.Results and Discussion
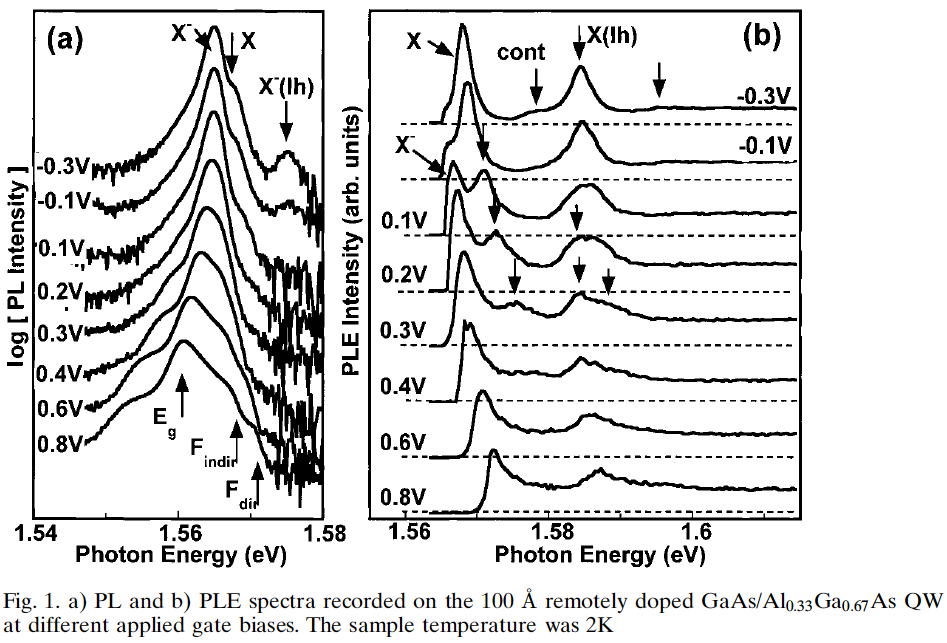
丂
丂Fig1a.偼gate揹埑傪曄偊偰揹巕擹搙傪憹壛偝偣偰(忋偐傜壓偵)敪岝(PL)傪庢偭偨丅偙偺data偼Kuecher偑斾妑揑嫹偄堜屗偺2DEGs偺敪岝偲帡偰偄傞丅
丂敪岝偑偳偙偐傜婲偙偭偰偄傞偺偐傪柾幃揑偵昞偡偲丄
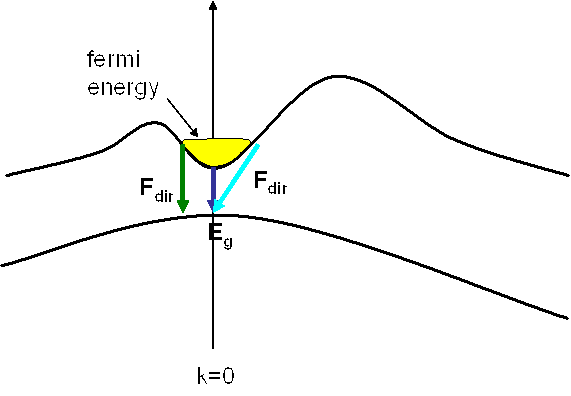
偱偁傞丅僶儞僪僊儍僢僾偲娫愙慗堏(indirect)偺娫偺峔憿偼shake-up-process偵傛傞傕偺偱偁傞傜偟偄丅彮偟媈栤偵側傞偺偑娫愙慗堏偼敪岝偟偯傜偄偺偵娫愙慗堏偺傎偆偑嫮偔弌偰偄傞偺偼壗偱偱偁傠偆丠hole懁偺庴偗擖傟愭偑懡偔偁傞偐傜偐丠indirect transition偺傎偆偑direct傛傝掅僄僱儖僊乕偵偁傞偺偼恾傪尒傟偽傢偐傞傛偆偵壙揹巕懷暘偺傊偙傒暘偩偗僄僱儖僊乕偩偗direct transition偼崅僄僱儖僊乕懁偵側傞丅
Fermi energy偲揹巕枾搙偼Eg偲Findirect偺尐偱奣嶼偟偰偄傞丅
揹巕枾搙偼capacitance偺應掕偲傛偔堦抳偟偨丅
揹埑傪0.1V偲偡傞偲charged exciton偺sharp側傕偺偑尒偊偨偟丄崅僄僱儖僊乕懁偵exciton傕弌尰偟偨丅charged exciton 偲 exciton偺僄僱儖僊乕嵎偼2.1meV丅
丂揹巕傪彮側偔偡傞偲fermi energy偑壓偑傞偺偱敪岝偼塻偔側傞丅PL傕high energy偺傎偆偵shift偟偰偄傞丅偙傟偺偁傑傝棟桼偼榓偐傜側偄丅
丂師偵fig.1(b)偺PLE偵娭偟偰媍榑偡傞丅gate bias傪-0.3V偲偡傞偲1s偺heavy-hole偺exciton(X)偺敪岝偲light-hole偺exciton(X(lh))偺敪岝偺椉曽偑尒傜傟傞丅偙傟傜偺敪岝偼摨偠僶僀傾僗偺僄僱儖僊乕偵帡偰偄傞丅(屄恖揑偵偼傎偲傫偳(X)偺傎偆偼堦抳偟偰偄傞偑丄(X倢倛)偺傎偆偼PLE偺傎偆偑崅僄僱儖僊乕懁偵偁傞傛偆偵尒偊傑偡偑)
丂X傗X(lh)偺偲偙傠偵偄偔偮偑偱偙傏偙偑尒傜傟傞偑丄偦傟傜偼2s,3s側偳偺偐傜偺敪岝偲懇敍偝傟偰偄側偄偲偙傠偐傜偺1s偲2s偺僄僱儖僊乕嵎偐傜heavy-hole exciton偺懇敍僄僱儖僊乕偼11.4meV峫偊傜傟傞丅
丂gate bias偑0.8V偺偲偒Fermi-edge-singularity偺偨傔偵媧廂偺鑷抣偱peak偑尒傜傟傞丅(偳偺偙偲傪尵偭偰傞傫傗)
偁傫傑傝偙偺帪揰偱偙偺榑暥偺尵偭偰偄傞堄枴偑傢偐傜側偄丅偲偄偆傛傝丄榖偵堦娧惈偑側偄傫偠傖側偄傫偲偍傕偆丅偦傫側偙偲傛傝幚尡僨乕僞偺傎偆偑嫽枴怺偔偼偁傞偑丄
Fig.1(b)偼charged-exciton偲exciton偺敪岝偑揹巕擹搙傪憹壛偝偣傞偵偮傟偰丄嫮搙偑擖傟懼傢偭偰偄傞偺偑嫽枴怺偄傗偼傝丄揹巕擹搙傪憹壛偝偣傞偵偮傟偰charged-exciton偺嫮搙偑嫮偔側偭偰偒偰偄傞丅偙偺偙偲偼PL偵娭偟偰傕摨條側偙偲偑偄偊傞丅
PLE偱揹巕擹搙傪憹壛偝偣傞偲peak偑崅僄僱儖僊乕懁偵shift偟偰偄傞偺偑傢偐傞偟偐傕僗儉乕僘偵FES偺peak偵偮側偑偭偰偄傞丅
摨帪偵exciton偺peak偼揹巕擹搙偑6亊1010cm-2偱尒暘偗傞偙偲偑擄偟偔側偭偰偄傞丅
偙偺傛偆側摿挜偼excito偺light-hole偵娭偟偰傕偐側傝揹巕擹搙偺娭偟偰帡偨傛偆側怳傞晳偄偵側偭偰偄傞丅